Основной задачей ФИП является растровое травление образцов сфокусированным пучком однозаряженных ионов галлия. Размеры области объектов, для которых оправдано использование методов ФИП, составляют величины от 0.2 мкм до 100 мкм. Ионный пучок формируется с использованием жидкометаллического источника ионов галлия и затем ускоряется до определенного значения энергии в диапазоне от 1 кэВ до 30 кэВ. Режим высоких ускоряющих напряжений используется для быстрого и прецизионного травления образца, а режим низких ускоряющих напряжений используется для полировки и очистки поверхности от артефактов травления.
Размер области на поверхности образца, в которую попадает 95% ионов сфокусированного пучка (размер ионного зонда), зависит от тока пучка и ускоряющего напряжения и составляет величину около 30 нм для минимального тока (30 кэВ @ 1 пА) и около 2000 нм для максимального тока (30 кэВ @ 20 нА). Разрешение травления определяется, главным образом, размером ионного зонда; его максимальное значение составляет величину около 50 нм для "отверстий" и около 20 нм для "перемычек". Скорость травления зависит от величины тока ионного пучка, плотности и структуры материала образца и параметров экспонирования, таких как последовательность прохождения точек экспонирования, расстояние между этими точками, и время нахождения пучка в точке экспонирования. Как пример, для монокристаллического кремния с ориентацией поверхности (110) при травлении пучком ионов галлия 30кэВ@4 нА, при растровом построчном травлении, с расстоянием между точками 500 нм, скорость травления составляет около 1.5 мкм3/с. Переосаждение распыляемого в ходе травления материала снижает эффективность травления глубоких и узких отверстий. Отношение глубины формируемого отверстия к его диаметру (аспектное соотношение) монотонно зависит от диаметра; для минимальных отверстий оно составляет величину около 1, для отверстий с диаметром больше 5 мкм оно может достигать 10 и более высоких значений. Основными применениями метода ФИП являются приготовление поперечных срезов микро- и нанобъектов, разрушающая трехмерная томография, ионная литография и приготовление образцов для просвечивающей электронной микроскопии (рис. 3.1).
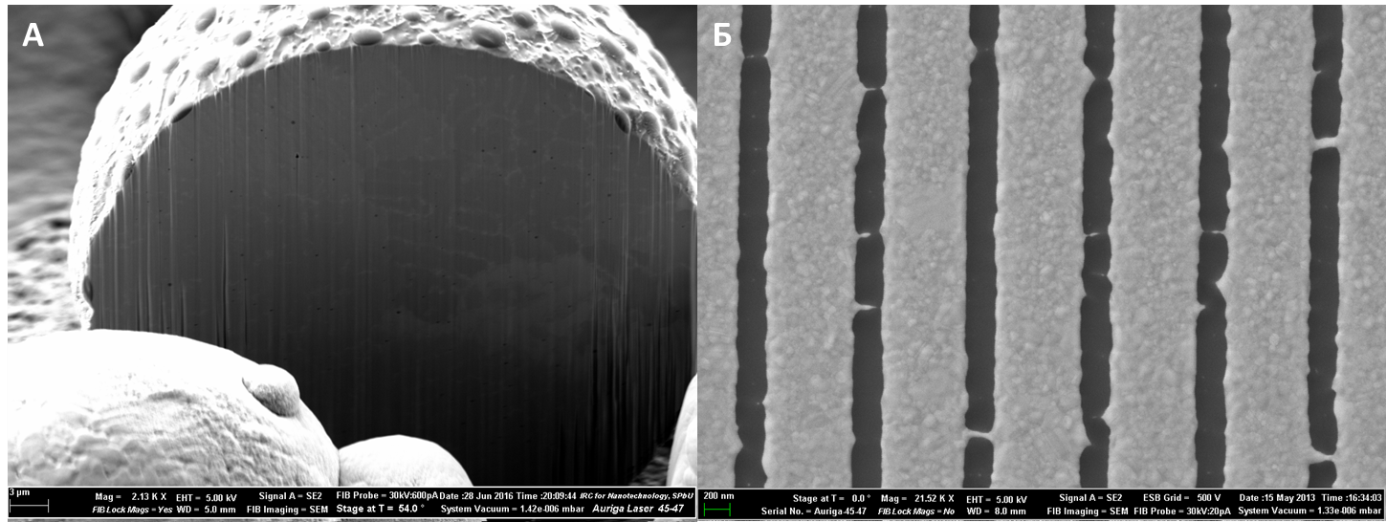
Рис. 3.1. А – поперечный срез микрочастицы сплава Инконель, приготовленный методом ФИП. Б – серия прорезей в 50 нм пленке серебра, изготовленная методом ФИП для генерации стоячих плазмонных колебаний.




